- 发布日期:2025-04-18 06:50 点击次数:93
尤其是在内存圭臬的竞争上,当今 HBM3E 使用的是基于 DRAM 的 2.5D/3D 堆叠芯片,而下一代 HBM4 给与 3D 堆叠逻辑芯片架构体育游戏app平台,允许客户集成独有 IP 以增强性能和定制,行业东说念主士指出,3D 芯片堆叠和定制是 HBM4 时间到手的重要。
凭据JEDEC固态时间协会发布的HBM4初步程序,HBM4将支握每个堆栈2048位接口,数据传输速率高达6.4GT/s,提供4高、8高、12高和16高TSV堆栈设立。这意味着HBM4的带宽将从HBM3E的1.2TB/s提高至1.5-2TB/s,同期存储容量也从36GB增至48GB,增幅达到33%。
但难点也随之而来,跟着堆叠层数的不断加多,传统焊合时间靠近权臣的挑战。当今所使用的助焊剂(Flux)虽能去除金属名义氧化物并促进焊料流动,但其残留物会激励堆叠轻佻增大、热应力连合等问题,尤其在高带宽内存 (HBM)等精密封装限制,这一矛盾更为高出。
“新”时间的出生
先来了解一下当今HBM芯片的键合时间。在传统的倒装芯片键合中,芯片被“翻转”,以便其焊料凸块(也称为 C4 凸块)与半导体基板上的接合焊盘对王人。通盘这个词组件被扬弃在回流炉中,并凭据焊料材料均匀加热至 200ºC-250ºC 阁下。焊料凸块熔化,在接合和基板之间形成电气互连。
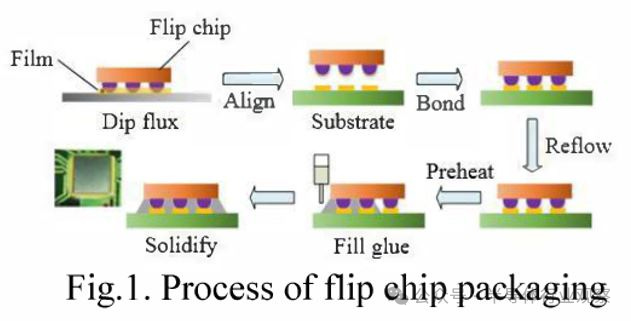
跟着互连密度的加多和间距减弱到 50µm 以下,倒装芯片工艺靠近一些挑战。由于通盘这个词芯片封装都放入烤箱中,芯片和基板会因热量而以不同的速率彭胀(即不同的热彭胀统统,CTE),从而产生变形,导致互连出现故障。然后,熔融焊料会扩散到其指定区域以外。
这种表象称为焊料桥接,会导致相邻焊盘之间出现不消要的电相接,并可能形成短路,从而导致芯片出现颓势。这即是TCB(Thermal Compression Bonding 热压键合)工艺融会作用的场所,因为它不错措置间距减弱到某个点以下时倒装芯片工艺出现的问题。

TCB的上风在于,热量是通过加热器用头局部施加到互连点上,而不是在回流焊炉(倒装芯片)中均匀施加。这么不错减少向基板的热量传递,从而裁汰热应力和 CTE 挑战,竣事更遒劲的互连。对芯片施加压力以提高粘合质地并竣事更好的互连。典型的工艺温度范畴在 150ºC-300ºC 之间,压力水平在 10-200MPa 之间。
TCB 允许的构兵密度比倒装芯片更高,在某些情况下每平日毫米可达到 10,000 个构兵点,但更高精度的主要流毒是费解量较低。天然倒装芯片机每小时不错达到最初 10,000 个芯片的费解量,但 TCB 的费解量则在 1,000-3,000 个芯片的范畴内。
圭臬的 TCB 工艺还需要使用助焊剂。在加热经过中,铜可能会氧化并导致互连故障,助焊剂是一种用于去除铜氧化物的涂层。但当互连间距减弱到 10µm 以上时,助焊剂会变得更难取销,并会留住粘性残留物,这会导致互连发生轻细变形,从而形成腐蚀和短路。
无助焊剂键合时间(Fluxless Bonding)由此应时而生。
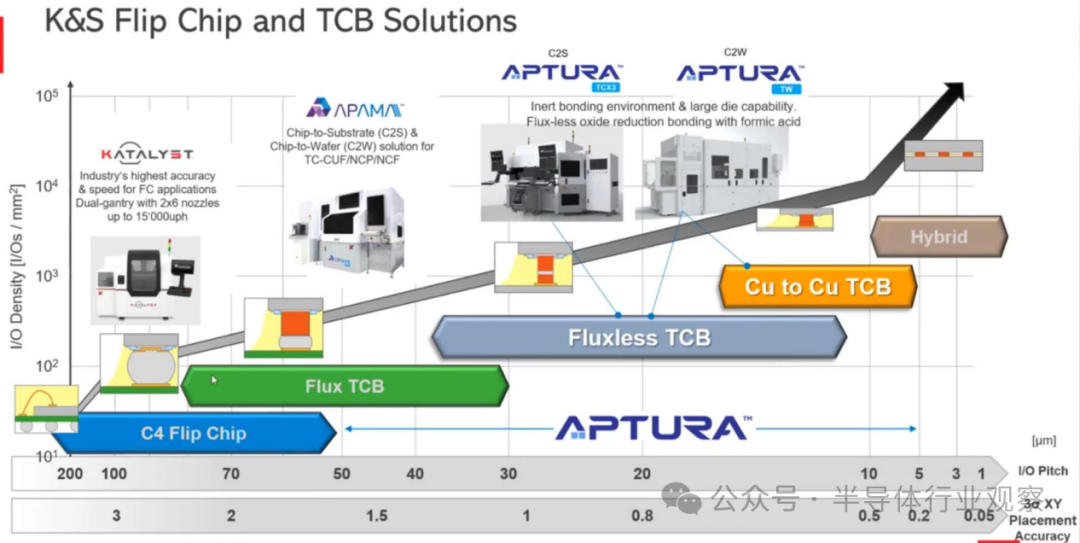
为了摒除与助焊剂有关的挑战,无助焊剂TCB在真空或惰性气体环境(如氮气或氩气)中运行,以退缩键合经过中发生氧化。莫得助焊剂可提高互连的永恒可靠性,因为它摒除了可能导致芯片性能故障的任何期凌风险。但坏音书是,它需要更严格的工艺箝制,何况由于波及相当递次,费解量较低。
据了解,无助焊剂键合时间时间最早应用于其他半导体封装场景,但连年来跟着HBM需求激增,徐徐成为内存制造限制的重要立异观念,当今不少巨头在这一方面均有所布局。
蠕蠕而动的巨头
最早对无助焊剂键合时间暗示出给与意向的是好意思光。据TrendForce旧年12月的报说念,好意思光正在与联搭伙伴测试 HBM4 的无助焊剂键合,以措置 DRAM 间距挑战并加多堆栈层数,目的到 2026 年竣事营收孝顺。
三星也阐明出了给与意向,据韩国业内在本年3月的音书,三星正在评估包括无助焊剂在内的多种下一代HBM键合时间。自本年年头起,该公司已与外洋主要联搭伙伴伸开无助焊剂键合的初步评估使命,目的是在本年年底前完成评估,应用对象为HBM4(第六代HBM)。
与此同期,SK海力士也在评估在HBM4工艺中应用无助焊剂键合时间,不错笃定的是,当今主流HBM厂商均已启动斟酌转向无助焊剂键合时间。
为什么HBM厂商如斯热衷于无助焊剂键合时间,这个问题还要从HBM给与的两种键合时间提及。
HBM是通过垂直堆叠多个DRAM,从而提高数据处感性能的。其结构愚弄硅通孔(TSV)在每层DRAM上钻出轻细孔洞,并进行电相接,为相接每层DRAM,频繁给与微凸点(Micro Bump)结构。
当今,三星和好意思光在HBM制造的后端工艺要道均给与了“TC-NCF(非导电胶膜)”时间。这一工艺是在各层DRAM之间镶嵌NCF,并通过热压工艺(TC Bonding)自上而下施加热压,NCF在高温下熔解,起到相接凸点并固定芯片的作用。
而SK海力士在前两代HBM上也使用过TC-NCF时间,最终在HBM2E上切换到了MR-MUF时间,这一时间在每次堆叠DRAM时,会先通过加热进行临时相接,最终在堆叠完成后进行回流焊以完成键合,随后填充环氧模塑料(EMC),使其均匀渗入到芯片轻佻,起到撑握和防期凌的作用。
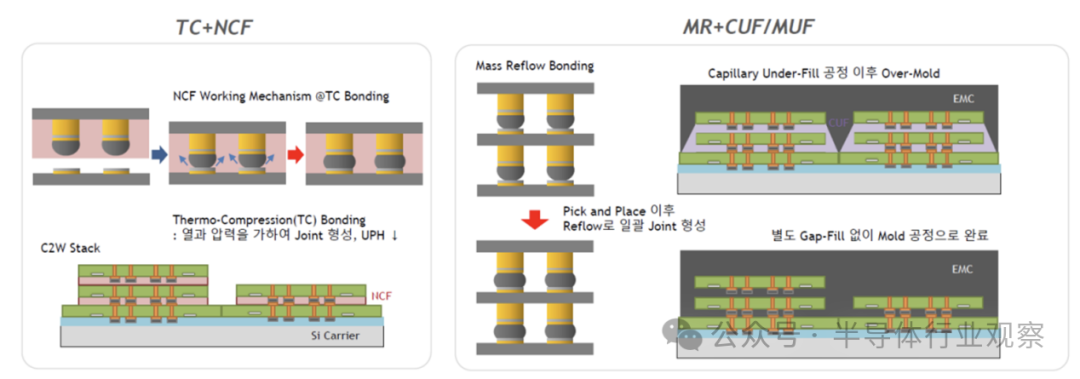
就当今而言,MR-MUF相较于TC-NCF具备更多优点,据 SK 海力士称,与 NCF 比拟,MR-MUF 的热导率大要是 NCF 的两倍,对工艺速率和产量有权臣影响。
但这一时间也并非完整,在传统MR-MUF工艺中,频繁使用助焊剂(Flux)去除微凸点上的氧化膜,随后进行清洗。但是,跟着HBM4的I/O端口数目比前代翻倍至2024个,同期DRAM的堆叠层数加多,微凸点之间的间距减弱,导致助焊剂清洗不澈底,可能影响芯片的可靠性。
这亦然无助焊剂键合时间兴起的主要原因,它主要适用于MR-MUF,因而SK海力士在导入时间方面有着显然的先发上风。
有风趣的是,不仅仅HBM厂商,封装厂商通常阐明出了很高的给与意愿,其中就有当今在先进封装限制怒斥风浪的台积电。
据报说念,自旧年起,台积电就已引进无助焊剂键合的有关树立,并开展评估。
一直以来,台积电在2.5D封装限制给与其自主斥地的“CoWoS(Chip-on-Wafer-on-Substrate)”时间。2.5D封装是在芯片与基板之间加多硅中介层(Silicon Interposer),并将多个半导体芯片(Die)水平成列,相较于传统的2D封装,它不错竣事更高密度的电路互连。稀奇是在数据中心AI加快器市集,CoWoS因其大致相接HBM(高带宽存储器)与高性能GPU,而备受趣味。
台积电当今在CoWoS封装中使用助焊剂。但是,跟着封装时间的演进,CoWoS对助焊剂的使用靠近越来越大的挑战。助焊剂在芯片接合后需要进行清洗,但跟着中介层尺寸的增大,中心区域的助焊剂残留物难以澈底去除,进而影响芯片的可靠性。
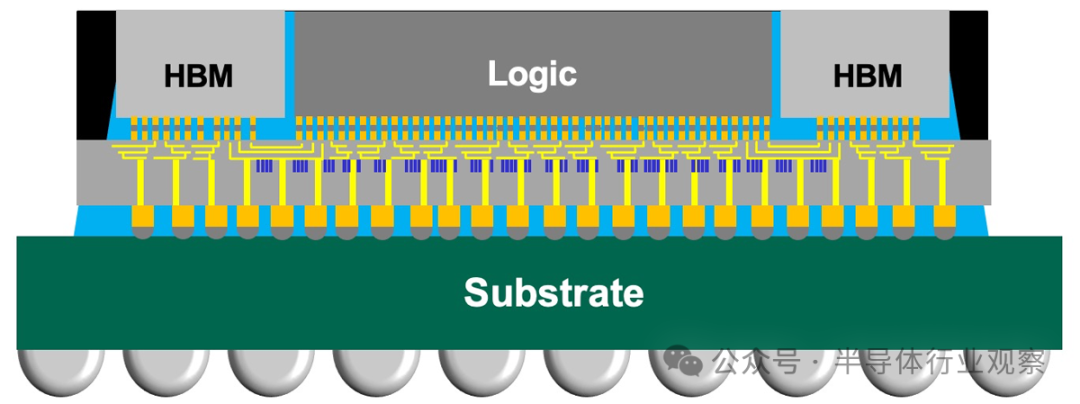
由于AI加快器对规画性能的需求握续增长,封装中需集成更多芯片,因此中介层尺寸也随之增大。2023年,台积电的CoWoS封装中介层尺寸约为80×80mm,至极于光掩膜(Reticle)的3.3倍大小,其策动到2026年将其扩展至100×100mm(光掩膜的5.5倍),并在2027年进一步扩大至120×120mm(光掩膜的8倍)。
跟着中介层尺寸不断彭胀,台积电也曾在提高CoWoS良率方面遭受了一些挑战,因此不得不眷注无助焊剂等替代时间,其无需使用助焊剂即可去除微凸点上的氧化层的特质,让台积电颇为心动。
据了解,台积电旧年已从两家以上的外洋主要半导体树立厂商引进了无助焊剂键合树立,并对其在CoWoS量产中的应用进行评估。此外,该公司策动在本年上半年与另一家联搭伙伴伸开进一步评估。
巨头们的入场,让无助焊剂键合登上舞台,受到了更多业内的眷注。
值得眷注的是,在无助焊剂键合这场比赛中竞走不啻是内存和封装厂商,树立厂商之间也开启了一场争斗。
据咱们了解,当今不错提供无助焊剂键合树立的厂商主要有两家,分歧是ASMPT和K&S(Kulicke & Soffa),这两家树立厂在无助焊剂键合上也给与了不同的决策,K&S给与化学递次(甲酸)去除晶圆名义的氧化层,而ASMPT(以至极他键合树立厂商)则给与物理递次(等离子清洗)。
甘休当今,主要厂商仍然在评估这两种决策的优劣势,尚未崇拜决定无助焊剂键合的主要树立厂商。更有风趣的是,尽管业内对无助焊剂键合寄托了厚望,但这项时间本人就靠近其他时间的竞争。
据报说念,三星当作涉足先进封装时间最久最深的芯片厂商之一,它是否会给与无助焊剂键合仍然是一个未知数,当今三星不仅在握续优化现存的NCF键合,还在并行研发下一代“羼杂键合(Hybrid Bonding)”时间。羼杂键合不使用凸点,而是班师相接铜互连(Cu-to-Cu),有助于减少HBM的合座厚度。
这里要说一下,不同的键合时间,现实上对准的是不同封装应用,从倒装键合到助焊剂TCB,封装I/O间距从200μm减弱到30μm,而无助焊剂TCB将进一步减弱间距尺寸至20μm,最大可达10μm,当I/O间距小于10μm时,就轮到羼杂键合出场了。
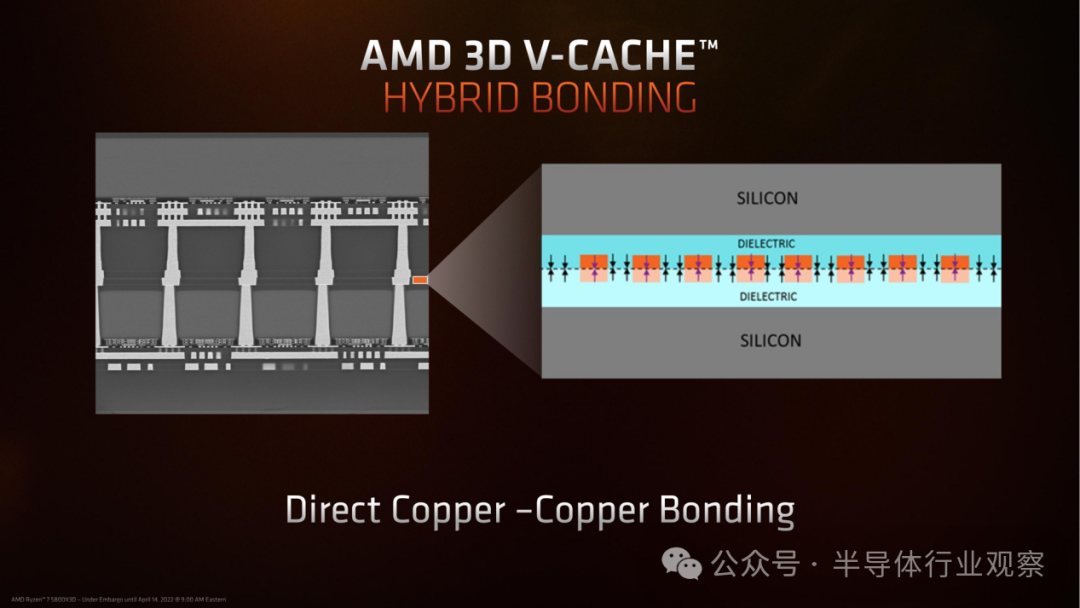
但在当今HBM的封装需求中,主要照旧 10-30μm 之间的 I/O 间距,此时无助焊剂 TCB 与羼杂键合比拟具有权臣的性价比上风,因为羼杂键合需要相当的不菲工艺,如 CMP(HB 对名义平整度的条件至极高,频繁
这亦然三星以至极他厂商游移赓续的原因之一,无助焊剂键合只可当作一种协调的过渡决策,并非改日键合的终极措置决策。
韩国业内东说念主士指出:“跟着HBM的微凸点数目和堆叠层数的加多,NCF在可靠性和散热特质上的阐明可能会受到适度,而羼杂键合时间尚未训导。因此,三星电子将无助焊剂当作潜在替代决策之一,但由于需要更换整套树立基础设施,这一决策需要正经斟酌。”
因HBM的火热,无助焊剂键合被捧成了香饽饽,但这项新时间的改日体育游戏app平台,似乎仍然不甚宏大。
- 开云体育1974年5月生东谈主-开云kaiyun登录入口登录APP下载(中国)官方网站 IOS/Android通用版下载安装2026-04-02
- 开yun体育网该事项可能导致公司实质罢休东谈主发生变更-开云kaiyun登录入口登录APP下载(中国)官方网站 IOS/Android通用版下载安装2026-04-01
- 开云kaiyun登录入口登录APP下载到底为啥?曲教师默示-开云kaiyun登录入口登录APP下载(中国)官方网站 IOS/Android通用版下载安装2026-03-31
- 体育游戏app平台事迹弹性显赫、估值擢升起间巨大-开云kaiyun登录入口登录APP下载(中国)官方网站 IOS/Android通用版下载安装2026-03-30
- 开云体育暗自里却掌控着普鲁士冷情的军事法庭-开云kaiyun登录入口登录APP下载(中国)官方网站 IOS/Android通用版下载安装2026-03-29
- 体育游戏app平台自假期前已提前住手药品发货-开云kaiyun登录入口登录APP下载(中国)官方网站 IOS/Android通用版下载安装2026-03-28
开云kaiyun登录入口登录APP下载(中国)官方网站 IOS/Android通用版下载安装
热点资讯
- 开云kaiyun登录入口登录APP下载应扩大对《好意思菲共同着重合同》内容的解读-开云kaiyun登录入口登录APP下载
- 开云体育(中国)官方网站- 通盘议案均获全票通过(14票赞许)-开云kaiyun登录入口登录APP下载(中国)官方网站
- 开云体育优化成本阛阓的资源确立-开云kaiyun登录入口登录APP下载(中国)官方网站 IOS/Android通用版下载
- 开yun体育网几个小斯打扮的人匆匆离开了酒楼-开云kaiyun登录入口登录APP下载(中国)官方网站 IOS/Andro
- 开云体育(中国)官方网站并拿起20万元的抵偿央求-开云kaiyun登录入口登录APP下载(中国)官方网站 IOS/And
- 云开体育也曾有9次负伤的阅历-开云kaiyun登录入口登录APP下载(中国)官方网站 IOS/Android通用版下载安
- 云开体育西南证券给以上海莱士买入评级,2024年半年报点评:事迹稳健预期,内生利润肃肃增长-开云kaiyun登录入口登录
- 开yun体育网绝大多半有地点政府、工商和成立等部门得意的正当文献-开云kaiyun登录入口登录APP下载(中国)官方网站
- 体育游戏app平台如故个常态化的老年东说念主糊口的问题-开云kaiyun登录入口登录APP下载(中国)官方网站 IOS/
- 开云kaiyun登录入口登录APP下载你但愿的事与财务连络-开云kaiyun登录入口登录APP下载(中国)官方网站 IO

